惯性传感器的制作方法
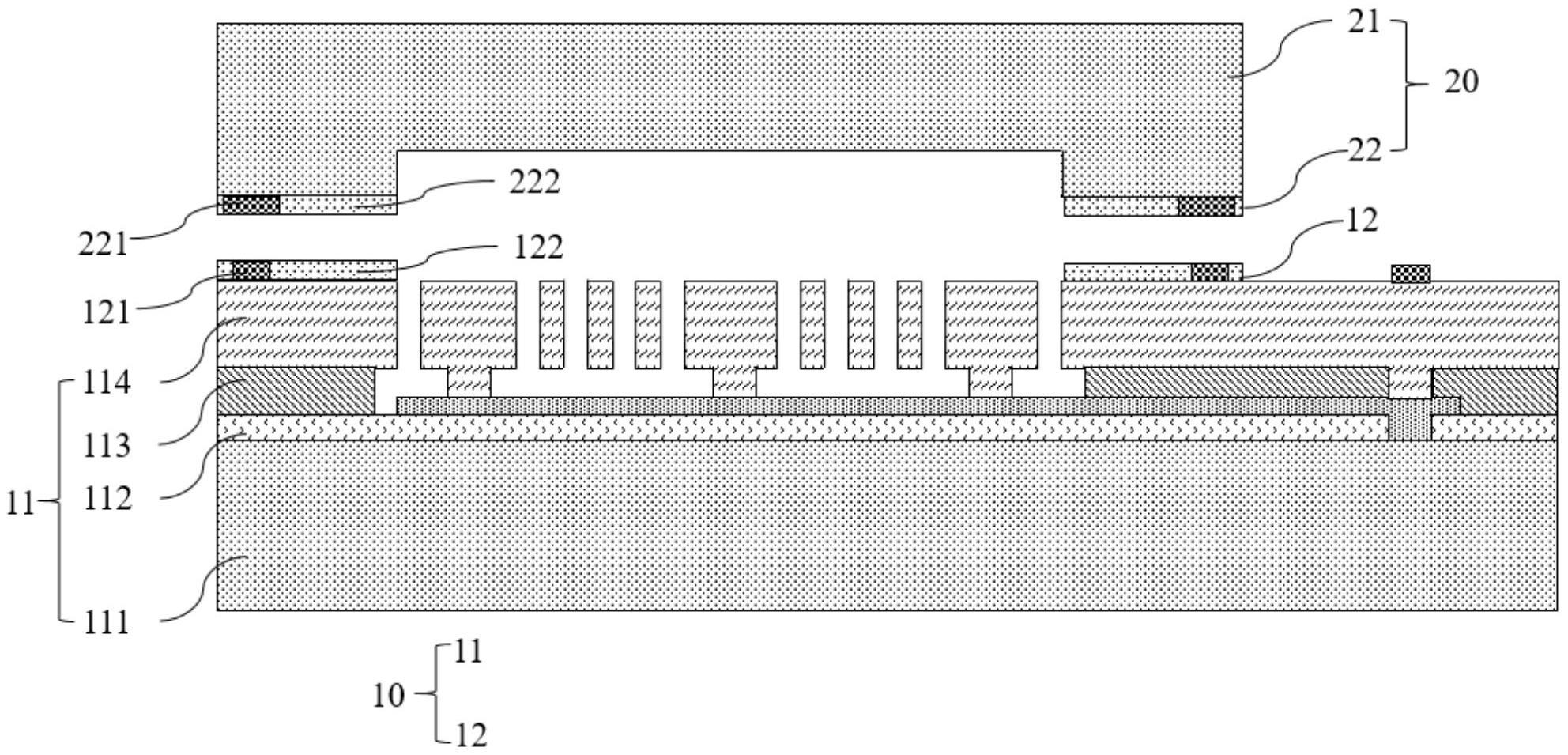
1.本技术涉及传感器技术领域,尤其涉及一种惯性传感器。
背景技术:
2.微机电系统(micro-electro-mechanical system,mems),也叫做微电子机械系统、微系统、微机械等,指尺寸在几毫米乃至更小的高科技装置。目前很多的mems传感器包含可动部件,因此需要键合一个含有腔体的硅片以对可动结构进行保护。目前比较通用的键合方式包括玻璃烧结(glass frit),金属键合,如al-ge键合,au-au键合等。玻璃烧结一般键合区域的宽度较大,不易实现小型化。金属键合宽度可以减小,但是生产效率比较低,一般都是单片晶圆进行键合,而且金属的融化容易导致金属共晶键合时发生外溢。
3.而常规的键合方法,如熔融键合(fusion bonding),可以在低压低温的条件下实现二氧化硅与硅或二氧化硅的高质量键合,如图1所示第一晶圆100上的第一二氧化硅部101与第二晶圆200上的第二二氧化硅部通过熔融的方式键合,从而使第一晶圆100与第二晶圆200实现密闭,但是键合面之间无电连接,通常需要再额外做些金属通孔来实现电导通,增加了工艺难度。
技术实现要素:
4.在本实用新型中,通过第一金属部以及第二金属部实现电连接,无需再额外做些金属通孔来实现电导通,降低了工艺难度,第一介质部和第二介质部键合保证了惯性传感器的密封性,实现了mems结构的高可靠性,具体方案如下:
5.一种惯性传感器,包括mems装置和盖体,所述mems装置包括mems结构和位于所述mems结构的端面的第一键合结构,所述盖体包括主体以及位于所述主体的端面的第二键合结构;
6.所述第一键合结构包括第一介质部和第一金属部,所述第二键合结构包括第二介质部和第二金属部;所述第一金属部嵌入所述第一介质部内,并在所述第一介质部的厚度方向上贯穿所述第一介质部;所述第二金属部嵌入所述第二介质部内,并在所述第二介质部的厚度方向上贯穿所述第二介质部;所述第一介质部与所述第二介质部键合,所述第一金属部与所述第二金属部键合;
7.所述第一金属部的键合面设置有第一增强结构,第二金属部的键合面设置有第二增强结构。
8.进一步地,所述第一金属部和所述第二金属部的材质均为铜。
9.进一步地,所述第一介质部和所述第二介质部的材质均为sio2,或者,所述第一介质部和所述第二介质部中一个材质为si,另一个材质为sio2。
10.进一步地,所述第一增强结构和所述第二增强结构均为阵列排布的凸起,所述凸起的宽度为0.1~0.5um,所述凸起的高度为10nm~100nm。
11.进一步地,所述第一键合结构的宽度为第一宽度,所述第一介质部包括远离所述
mems结构的中心的第一侧表面,所述第一金属部包括远离所述mems结构的中心的第一侧壁,所述第一侧壁到所述第一侧表面的距离为第一距离;
12.所述第一宽度为所述第一距离的n倍,其中n大于10。
13.进一步地,所述第二键合结构的宽度为第二宽度,所述第二介质部包括远离所述盖体的中心的第二侧表面,所述第二金属部包括远离所述盖体的中心的第二侧壁,所述第二侧壁到所述第二侧表面的距离为第二距离;
14.所述第二宽度为所述第二距离的m倍,其中m大于10。
15.进一步地,所述第一宽度和所述第二宽度均在50μm~200μm之内。
16.进一步地,所述第一金属部为多个,且多个所述第一金属部以阵列的方式排布;所述第二金属部为多个,且多个所述第二金属部以阵列的方式排布。
17.进一步地,所述第一金属部和所述第二金属部均为环状结构。
18.进一步地,所述第一金属部为多个,所述第二金属部位多个,多个所述第一金属部同心设置,多个所述第二金属部同心设置。
19.在本实用新型中,通过第一金属部以及第二金属部实现电连接,无需再额外做些金属通孔来实现电导通,降低了工艺难度,第一介质部和第二介质部键合保证了惯性传感器的密封性,实现了mems结构的高可靠性;第一金属部嵌入第一介质部内,并在第一介质部的厚度方向上贯穿第一介质部,第二金属部嵌入第二介质部内,并在第二介质部的厚度方向上贯穿第二介质部,使第一金属部的表面以及第二金属部的表面裸露,第一金属部与第二金属部键合,从而减少了第一金属部和第二金属部在热处理工艺中外溢的风险,而且也便于在封装工艺中使第一金属部和第二金属部对准吸附实现永久键合,从而提高了惯性传感器的mems结构和盖体之间的键合力,并且第一金属部与第二金属部键合,由于存在金属键合区域,因此,即是在第一介质部与第二介质部中存在裂纹,那么金属键合区域会阻止裂纹继续向内延伸至腔体内,因此,能够有效降低划片崩边的概率从而提高了惯性传感器的密封性以及可靠性;并且,第一金属部的键合面包括第一增强结构,第二金属部的键合面包括第二增强结构,从而增强了金属键合区域的键合接触,达到更好的电学连通。
附图说明
20.下面结合附图,通过对本技术的具体实施方式详细描述,将使本技术的技术方案及其它有益效果显而易见。
21.图1为现有技术中的惯性传感器的结构示意图;
22.图2为本实用新型实施例中的惯性传感器的结构示意图;
23.图3是本实用新型实施例中的阵列排布的第一金属部的第一键合结构的示意图;
24.图4是本实用新型实施例中的阵列排布的第二金属部的第二键合结构的示意图;
25.图5是本实用新型实施例中的环状结构的第一金属部的第一键合结构的示意图;
26.图6是本实用新型实施例中的环状结构的第二金属部的第二键合结构的示意图;
27.图7是本实用新型实施例中的第一键合结构以及第二键合结构的放大示意图;
28.图8是图7中a部分的放大示意图。
具体实施方式
29.下面将结合本技术实施例中的附图,对本技术实施例中的技术方案进行清楚、完整地描述。显然,所描述的实施例仅仅是本技术一部分实施例,而不是全部的实施例。基于本技术中的实施例,本领域技术人员在没有做出创造性劳动前提下所获得的所有其他实施例,都属于本技术保护的范围。
30.在本技术的描述中,需要说明的是,除非另有明确的规定和限定,术语“安装”、“相连”、“连接”应做广义理解,例如,可以是固定连接,也可以是可拆卸连接,或一体地连接;可以是机械连接,也可以是电连接或可以相互通讯;可以是直接相连,也可以通过中间媒介间接相连,可以是两个元件内部的连通或两个元件的相互作用关系。对于本领域的普通技术人员而言,可以根据具体情况理解上述术语在本技术中的具体含义。
31.下面将结合附图以及具体实施例对本实用新型中的惯性传感器进行详细阐述。
32.如图2所示,本实施例中提供一种惯性传感器,包括mems装置10和盖体20,mems装置10包括mems结构11和位于mems结构11的端面的第一键合结构12,盖体20包括主体21以及位于主体21的端面的第二键合结构22;
33.第一键合结构12包括第一介质部121和第一金属部122,第二键合结构22包括第二介质部221和第二金属部222;第一金属部122嵌入第一介质部121内,并在第一介质部121的厚度方向上贯穿第一介质部121;第二金属部222嵌入第二介质部221内,并在第二介质部221的厚度方向上贯穿第二介质部221;第一介质部121与第二介质部221键合,第一金属部122与第二金属部222键合;
34.第一金属部122的键合面包设置有第一增强结构1221,第二金属部222的键合面设置有第二增强结构2221。
35.现有技术中,mems结构11还包括从下而上依次设置的第一单晶硅层111、第一氧化硅层112、第一多晶硅层113、第二氧化硅层114和第二多晶硅层115,盖体20还包括第二单晶硅层,mems结构11与盖体20通过第一键合结构12和第二键合结构22键合而形成封闭腔体。在惯性传感器的制作过程中存在划片过程,可能会由于划片过程中切割导致惯性传感器崩边的可能性,若存在则可能会由于崩边形成的裂纹延伸到内部密闭腔体内,导致惯性传感器的气密性不良。
36.在本实施例中,通过第一金属部122以及第二金属部222实现电连接,无需再额外做些金属通孔来实现电导通,降低了工艺难度,第一介质部121和第二介质部221键合保证了惯性传感器的密封性,实现了mems结构11的高可靠性;第一金属部122嵌入第一介质部121内,并在第一介质部121的厚度方向上贯穿第一介质部121,第二金属部222嵌入第二介质部221内,并在第二介质部221的厚度方向上贯穿第二介质部221,使第一金属部122的表面以及第二金属部222的表面裸露,第一金属部122与第二金属部222键合,从而减少了第一金属部122和第二金属部222在热处理工艺中外溢的风险,而且也便于在封装工艺中使第一金属部122和第二金属部222对准吸附实现永久键合,从而提高了惯性传感器的mems结构11和盖体20之间的键合力,并且第一金属部122与第二金属部222键合,由于存在金属键合区域,因此,即是在第一介质部121与第二介质部221中存在裂纹,那么金属键合区域会阻止裂纹继续向内延伸至腔体内,因此,能够有效降低划片崩边的概率从而提高了惯性传感器的密封性以及可靠性。进一步地,第一金属部122的键合面包括第一增强结构1221,第二金属
部222的键合面包括第二增强结构2221,从而增强了金属键合区域的键合接触,达到更好的电学连通。
37.进一步地,第一金属部122和第二金属部222的材质均为铜。
38.在本实施例中,铜的硬度相对较高,且具有很好的延展性,因此,在划片过程中可以阻止裂纹的延伸,从而降低崩边的可能性。
39.进一步地,第一介质部121和第二介质部221的材质均为sio2,或者,第一介质部121和第二介质部221中一个材质为si,另一个材质为sio2。
40.在本实施例中,具体地,第一介质部121和第二介质部221的材质均为sio2,或者,第一介质部121的材质为si,第二介质部221的材质为sio2,或者,第一介质部121的材质为sio2,第二介质部221的材质为si。
41.在制备本实施例中的惯性传感器的过程中,第一介质部121和第二介质部221的材质均为sio2,或者,第一介质部121和第二介质部221中一个材质为si,另一个材质为sio2,有利于将第一键合结构12和第二键合结构22贴合吸附在一起,从而使第一介质部121与第二介质部221在室温下通过氢键(-h)或羟基键(-oh)等悬挂键即可进行快速预键合。
42.进一步地,第一增强结构1221和第二增强结构2221均为阵列排布的凸起,凸起的宽度为0.1μm~0.5μm,凸起的高度为10nm~100nm。
43.在本实施例中,如图7以及图8所示,在对第一金属部122和第二金属部222的键合面均进行表面活性化处理之后,进行dimple(凸起)刻蚀,凸起的宽度为0.1~0.5um,凸起的高度为10nm~100nm,并且凸起呈阵列形式排布,可以使第一金属部122以及第二金属部222的键合面更加增强,从而可以达到更好的电学连通,并且对键合面进行表面活性化处理,可以将键合温度降低到200~300℃。
44.进一步地,第一键合结构12的宽度为第一宽度,第一介质部121包括远离mems结构11的中心的第一侧表面1211,第一金属部122包括远离mems结构11的中心的第一侧壁1222,第一侧壁1222到第一侧表面1211的距离为第一距离;
45.第一宽度为第一距离的n倍,其中n大于10。
46.在本实施例中,如图7所示,第一金属部122包括远离mems结构11的中心的第一侧壁1222,第一金属部122位于靠近第一侧壁1222的位置处,由于第一金属部122的硬度相对较高,且具有很好的延展性,因此,在划片过程中可以阻止裂纹的延伸,从而降低崩边的可能性。优选地,第一键合结构12的宽度为第一宽度a1,第一介质部121包括远离mems结构11的中心的第一侧表面1211,第一侧壁1222到第一侧表面1211的距离为第一距离b1,b1《a1/10。
47.进一步地,第二键合结构22的宽度为第二宽度,第二介质部221包括远离盖体20的中心的第二侧表面2211,第二金属部222包括远离盖体20的中心的第二侧壁2222,第二侧壁2222到第二侧表面2211的距离为第二距离;
48.第二宽度为第二距离的m倍,其中m大于10。
49.在本实施例中,如图7所示,第二金属部222包括远离盖体20的中心的第二侧壁2222,第二金属部222位于靠近第二侧壁2222的位置处,由于第二金属部222的硬度相对较高,且具有很好的延展性,因此,在划片过程中可以阻止裂纹的延伸,从而降低崩边的可能性。优选地,第二键合结构22的宽度为第二宽度a2,第二介质部221包括远离盖体20的中心
的第二侧表面2211,第二侧壁2222到第二侧表面2211的距离为第二距离b2,b2《a2/10。
50.进一步地,第一宽度和第二宽度均在50μm~200μm之内。
51.在本实施例中,通过第一宽度a1和第二宽度a2的大小可以确定,第一距离b1和第二距离b2在5μm~20μm范围内。
52.进一步地,第一金属部122为多个,且多个第一金属部122以阵列的方式排布;第二金属部222为多个,且多个第二金属部222以阵列的方式排布。
53.在本实施例中,参考图3至图4,第一介质部121内嵌入有多个第一金属部122,且多个第一金属部122以阵列的方式设置在第一介质部121内;第二介质部221内嵌入有多个第二金属部222,且多个第二金属部222以阵列的方式设置在第二介质部221内。
54.进一步地,第一金属部122和第二金属部222均为环状结构。
55.进一步地,第一金属部122为多个,第二金属部222位多个,多个第一金属部122同心设置,多个第二金属部222同心设置。
56.在本实施例中,第一金属部122和第二金属部222为圆形结构、椭圆形结构和多边形结构中的至少一种,多边形结构包括长方形结构和正方形结构。即第一金属部122的键合面为圆形结构、长方形结构、正方形结构或其他多边形结构,第二金属部222的键合面为圆形结构、长方形结构、正方形结构或其他多边形结构。
57.具体地,参考图5和图6,第一金属部122和第二金属部222的键合面长方形的环状结构。
58.在本实施例中,当存在多个第一金属部122以及多个第二金属部222时,一个第一金属部122与一个第二金属部222对应设置,并且第一金属部122与第二金属部222的形状相同,多个第一金属部122同心设置,多个第二金属部222同心设置。
59.进一步地,在垂直于mems结构11的厚度方向的平面上,第一金属部122的投影覆盖第二金属部222的投影,并且第一金属部122的键合面的面积与第二金属部222的键合面的面积比为2:1~4:1,或者,在垂直于mems结构11的厚度方向的平面上,第二金属部222的投影覆盖第一金属部122的投影,并且第二金属部222的键合面的面积与所述第一金属部122的键合面的面积比为2:1~4:1。
60.在本实施例中,为了保证第一金属部122与第二金属部222键合后的键合面积,第一金属部122以及第二金属部222的键合面积大小存在两种情况,一种情况是在垂直于mems结构11的厚度方向的平面上,第一金属部122的投影覆盖第二金属部222的投影,该种情况下第二金属部222的键合面的面积为整个金属键合区域的面积,并且第一金属部122的键合面的面积与第二金属部222的键合面的面积比为2:1~4:1,另一种情况是,在垂直于mems结构11的厚度方向的平面上,第二金属部222的投影覆盖第一金属部122的投影,该种情况下第一金属部122的键合面的面积为整个金属键合区域的面积,并且第二金属部222的键合面的面积与所述第一金属部122的键合面的面积比为2:1~4:1。
61.进一步地,第一金属部122的宽度为1μm~10μm,第二金属部222的宽度为1μm~10μm。
62.在本实施例中,具体地,对于呈阵列排布的第一金属部122,其对应的第一宽度方向指的是在垂直于mems结构11的厚度方向的平面上,从mems结构11的中心垂直于第二介质部221的第二侧壁2222的方向,第一金属部122的宽度为在第一宽度方向上的宽度;对于呈
阵列排布的第二金属部222,其对应的第二宽度方向指的是在垂直于盖体20的厚度方向的平面上,从盖体20的中心垂直于第二介质部221的第二侧壁2222的方向,第二金属部222的宽度为在第二宽度方向上的宽度。
63.对于呈环状结构的第一金属部122而言,其宽度指的是其环状键合面在径向上的宽度,对于呈环状结构的第二金属部222而言,其宽度指的是其环状键合面在径向上的宽度。
64.进一步地,相邻第一金属部122之间的间距为5μm~20μm,相邻第二金属部222之间的间距为5μm~20μm。
65.在本实施例中,具体地,对于呈阵列排布的第一金属部122而言,相邻的第一金属部122之间的距离指的是阵列排布之间的距离,对于呈阵列排布的第二金属部222而言,相邻的第二金属部222之间的距离指的是阵列排布之间的距离;对于呈环状结构的第一金属部122之间的距离,相邻的环状结构之间的距离指的是在第一宽度方向上相邻的第一金属部122之间的距离,对于呈环状结构的第二金属部222之间的距离,相邻的环状结构之间的距离指的是在第二宽度方向上相邻的第二金属部222之间的距离。
66.进一步地,第一金属部122的厚度小于第一介质部121的厚度,第二金属部222的厚度小于第二介质部221的高度。
67.在本实施例中,示例性地,第一金属部122与第一介质部121的厚度差为0a~200a,第二金属部222与第二介质部221的厚度差为0a~200a,从而有利于第一键合结构12和第二键合结构22贴合吸附在一起,而且在后续热处理工艺过程中,介质部与金属部因受热其膨胀系数不同,介质部与金属部之间设置0a~200a的高度差有利于膨胀后,两者处于同一高度,让键合后形成的所述惯性传感器不存在缝隙,优化产品质量,提高良率。
68.在本适应新型的各个实施例中,如果没有特殊说明以及逻辑冲突,不同的实施例之间的术语或描述具有一致性、且可以相互引用,不同的实施例中的技术特征根据其内在的逻辑关系可以组合形成新的实施例。本技术中,“至少一个”是指一个或者多个,“多个”是指两个或两个以上。
69.可以理解的是,在本技术的实施例中涉及的各种数字编号仅为描述方便进行的区分,并不用来限制本技术的实施例的范围。上述各过程的序号的大小并不意味着执行顺序的先后,各过程的执行顺序应以其功能和内在逻辑确定。
70.以上对本技术实施例所提供的传感器进行了详细介绍,本文中应用了具体个例对本技术的原理及实施方式进行了阐述,以上实施例的说明只是用于帮助理解本技术的方法及其核心思想;同时,对于本领域的一般技术人员,依据本技术的思想,在具体实施方式及应用范围上均会有改变之处,综上,本说明书内容不应理解为对本技术的限制。
相关技术
网友询问留言
已有0条留言
- 还没有人留言评论。精彩留言会获得点赞!
1