一种硅压阻式压力传感器封装结构及封装方法
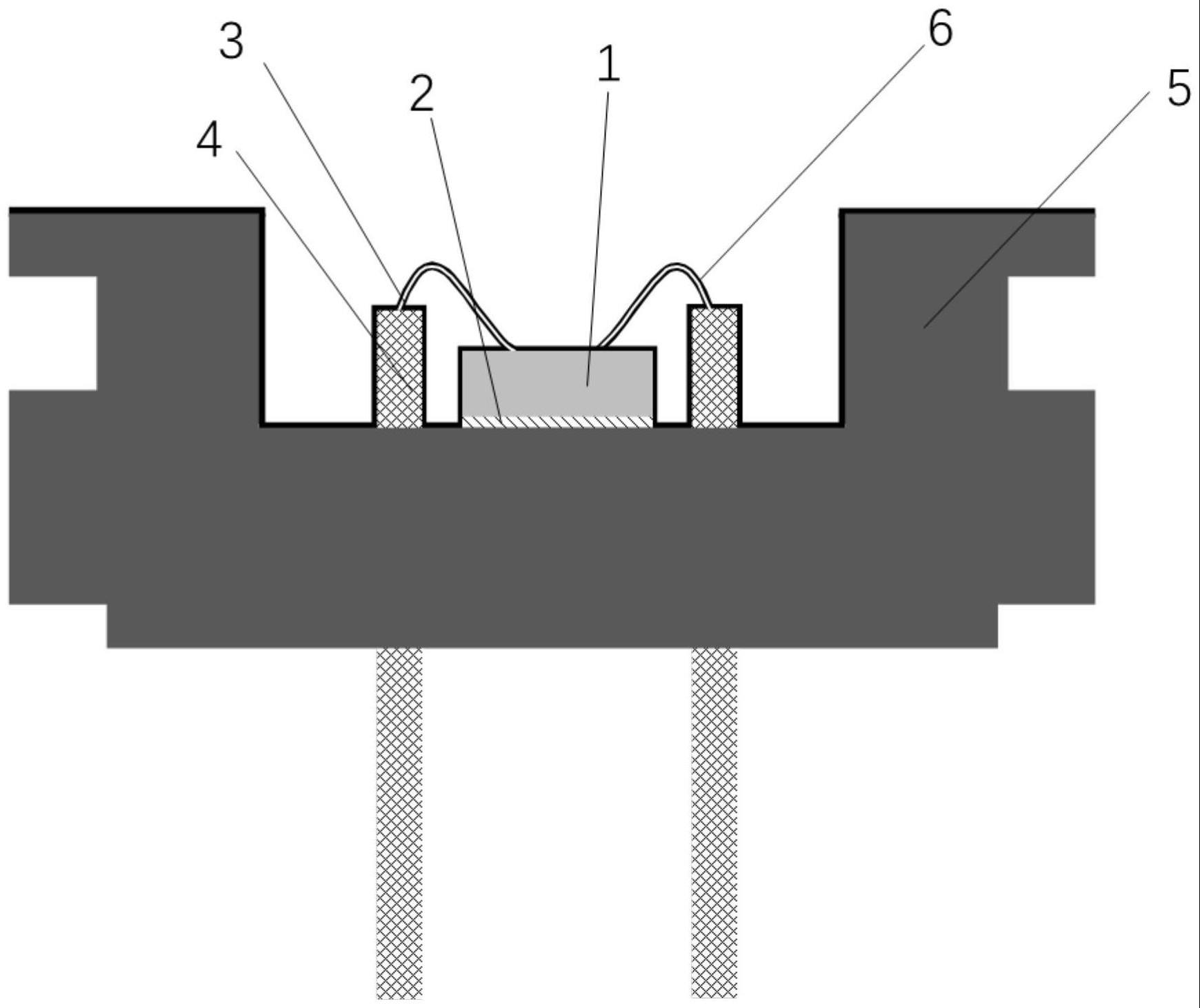
1.本发明涉及微电子机械系统领域,具体涉及一种硅压阻式压力传感器的封装结构和封装方法。
背景技术:
2.目前硅压阻式压力传感器通常采用在金属膜片与硅压力传感器芯片间充满硅油或硅凝胶的方式进行封装。中国专利cn2886532y公开了一种微压耐腐蚀压力传感器,它包括一个带有引线、参考压腔的金属壳体,一金属膜片,一压焊环,金属壳体内粘接硅压力传感器芯片,金属膜片与压焊环采用激光焊接连接,金属膜片与传感器芯片间充满硅油。中国专利公开说明书cn101271029a公开了一种硅压阻式压力传感器封装结构,其结构与上述类似,将传压介质更换为硅凝胶。这样封装的压力传感器制造难度大,成本高、体积大、无法批量加工。
技术实现要素:
3.本发明的目的是提供一种硅压阻式压力传感器的封装结构,其工艺简单、成本低廉、成品体积小、可并行加工。
4.为实现上述目的,本发明采用如下技术方案:
5.一种硅压阻式压力传感器封装结构,包括硅压阻式压力传感器芯片、接线基座、键合引线、派瑞林(parylene)薄膜,其特征在于:所述接线基座上设有引线柱,硅压阻式压力传感器芯片通过粘胶固定在接线基座上,硅压阻式压力传感器芯片通过键合引线与引线柱实现电信号连接,派瑞林薄膜覆盖包裹硅压阻式压力传感器芯片和键合引线,起到隔离介质,保护压力传感器芯片和键合引线的作用。
6.其中,所述派瑞林薄膜的厚度优选为0.5nm~2μm。
7.本发明所述的硅压阻式压力传感器的封装结构的具体实现步骤包括:
8.1.使用粘胶将硅压阻式压力传感器芯片贴装到接线基座上,加热固化;
9.2.使用键合引线将硅压阻式压力传感器芯片的输入输出电极与接线基座的引线柱连接;
10.3.通过化学气相沉积将派瑞林薄膜淀积到硅压阻式压力传感器芯片表面,使派瑞林薄膜覆盖包裹硅压阻式压力传感器芯片和键合引线;
11.4、通过高低温冲击试验释放薄膜的残余应力。
12.上述步骤1中,所述粘胶可以选择h70e,加热温度控制在125℃。
13.上述步骤3中,化学气相沉积派瑞林的温度为22~25℃,压力为10~30mtorr。
14.上述步骤4中,所述高低温冲击试验条件是低温-55℃至-20℃、高温80℃至130℃,各保持1~15分钟,循环多次。
15.本发明提供的硅压阻式压力传感器芯片封装结构可以有效减少封装体积,降低封装难度,且由于化学气相沉积法具有可同批次多传感器淀积的特点,本发明方法还具有可
以大批量并行加工的特点,有效降低硅压阻式压力传感器的封装成本。
附图说明
16.图1为本发明提供的硅压阻式压力传感器的封装结构示意图;
17.图中各数字代表的含义为:
18.1-硅压阻式压力传感器芯片,2-粘胶,3-键合引线,4-引线柱,5-接线基座,6-派瑞林薄膜。
具体实施方式
19.下面结合附图,通过实施例进一步阐述本发明。
20.如图1所示,将硅压阻式压力传感器芯片1通过粘胶2固定在接线基座5上,通过键合引线3将硅压阻式压力传感器芯片1上的输入输出电极与引线柱4相连,之后使用化学气相沉积法将派瑞林淀积在压力传感器芯片表面,形成覆盖包裹硅压阻式压力传感器芯片1和键合引线3的派瑞林薄膜6。
21.派瑞林薄膜淀积完成后,通过高低温冲击试验释放薄膜的残余应力,以消除残余应力对硅压阻式传感器特性的影响,高低温冲击试验条件是低温-55摄氏度、高温130摄氏度,各保持10分钟,共进行20次循环。
22.需要注意的是,公布实施例的目的在于帮助进一步理解本发明,但是本领域的技术人员可以理解:在不脱离本发明及所附权利要求的精神和范围内,各种替换和修改都是可能的。因此,本发明不应局限于实施例所公开的内容,本发明要求保护的范围以权利要求书界定的范围为准。
技术特征:
1.一种硅压阻式压力传感器封装结构,包括硅压阻式压力传感器芯片、接线基座、键合引线和派瑞林薄膜,其中所述接线基座上设有引线柱,硅压阻式压力传感器芯片通过粘胶固定在接线基座上,硅压阻式压力传感器芯片通过键合引线与引线柱实现电信号连接,派瑞林薄膜覆盖包裹硅压阻式压力传感器芯片和键合引线。2.如权利要求1所述硅压阻式压力传感器封装结构,其特征在于,所述派瑞林薄膜的厚度为0.5nm~2μm。3.权利要求1或2所述硅压阻式压力传感器的封装方法,包括以下步骤:1)使用粘胶将硅压阻式压力传感器芯片贴装到接线基座上,加热固化;2)使用键合引线将硅压阻式压力传感器芯片的输入输出电极与接线基座的引线柱连接;3)通过化学气相沉积将派瑞林薄膜淀积到硅压阻式压力传感器芯片表面,使派瑞林薄膜覆盖包裹硅压阻式压力传感器芯片和键合引线;4)通过高低温冲击试验释放薄膜的残余应力。4.如权利要求3所述的封装方法,其特征在于,步骤1)中所述粘胶为h70e。5.如权利要求3所述的封装方法,其特征在于,步骤1)中加热温度为125℃。6.如权利要求3所述的封装方法,其特征在于,步骤3)化学气相沉积的温度为为22~25℃,压力为10~30mtorr。7.如权利要求3所述的封装方法,其特征在于,步骤4)所述高低温冲击试验的条件是低温-55℃至-20℃、高温80℃至130℃,各保持1~15分钟,循环多次。
技术总结
本发明公开了一种硅压阻式压力传感器封装结构及封装方法,所述硅压阻式压力传感器芯片通过粘胶固定在接线基座上,硅压阻式压力传感器芯片的输入输出电极通过键合引线与引线柱实现电信号连接,通过化学气相沉积的方法将派瑞林薄膜覆盖包裹硅压阻式压力传感器芯片和键合引线,起到隔离介质,保护压力传感器芯片和键合引线的作用。该封装结构可以有效减少封装体积,降低封装难度,且由于化学气相沉积法具有可同批次多传感器淀积的特点,可以进行大批量并行加工,有效降低硅压阻式压力传感器的封装成本。的封装成本。的封装成本。
技术研发人员:聂少校 孟凡瑞 高成臣 杨振川
受保护的技术使用者:北京大学
技术研发日:2023.04.19
技术公布日:2023/7/22
相关技术
网友询问留言
已有0条留言
- 还没有人留言评论。精彩留言会获得点赞!
1