MEMS器件及其制备方法与流程
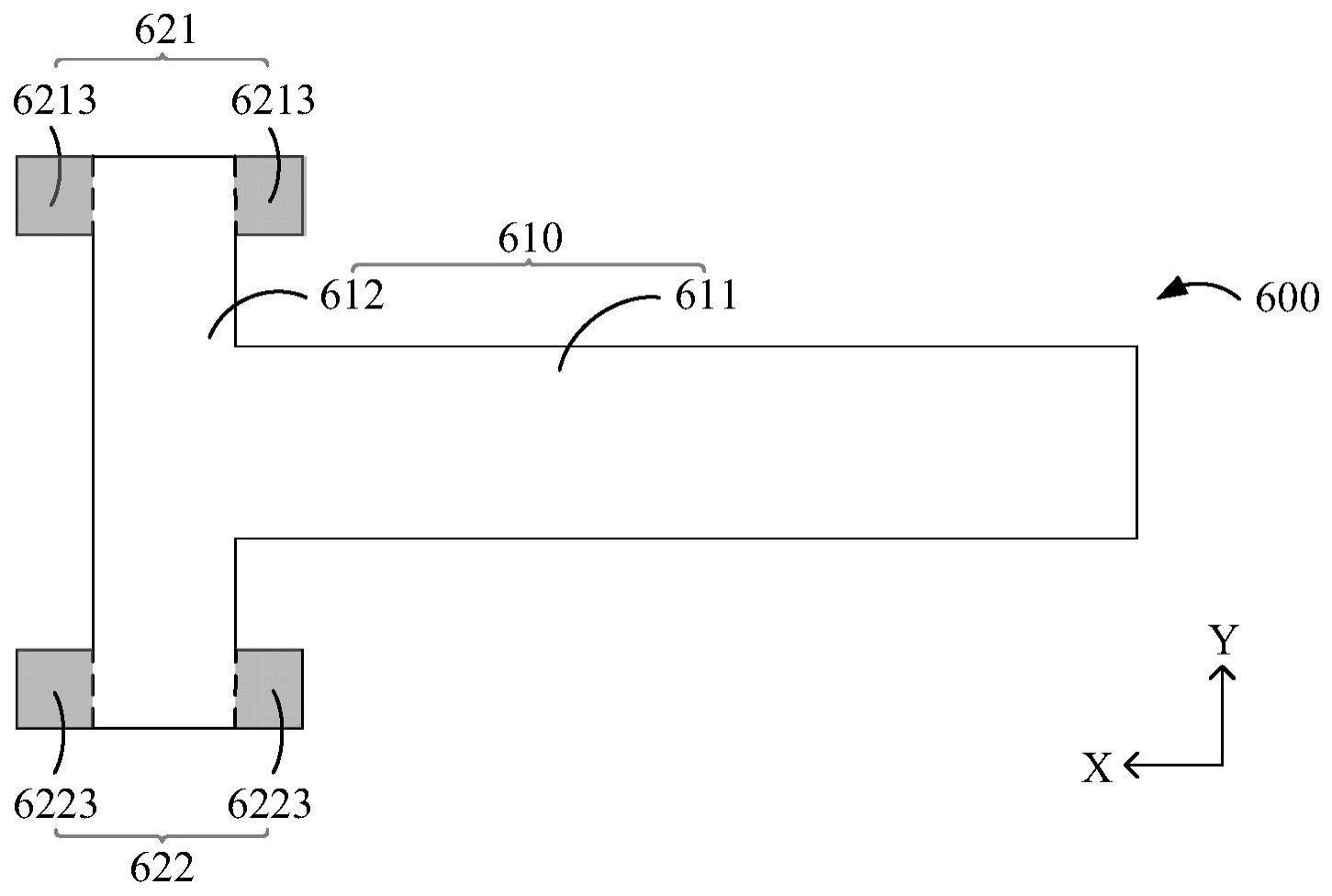
mems器件及其制备方法
技术领域
1.本技术涉及电子技术领域,具体涉及一种mems器件及其制备方法。
背景技术:
2.mems(micro-electro-mechanical system,微机电系统)是将微电子技术与机械工程融合到一起的一种工业技术。mems器件是利用mems技术制作的一种机械可动结构。作为mems器件的一类,mems谐振器是通过机电耦合作用,实现对电信号的选频滤波功能。mems谐振器具有以下优点:体积小、功耗低、抗冲击,与微电子集成电路工艺兼容、易于系统集成、性能稳定,可靠性高,而且工作频率集中在射频波段,最高可达ghz量级,品质因数高。
3.就静电电容式的mems谐振器来说,目前主要采用两种制备工艺方案,其一是采用soi衬底的体硅深刻蚀工艺,采用顶层硅作为谐振器的结构层,其优点是无膜层应力,谐振结构频率无漂移,但是器件制作成本较高;另一是采用多次薄膜沉积并刻蚀的平面工艺,以沉积的多晶硅薄膜作为结构层,此方案的优点是与cmos工艺兼容,成本相对较低,但是由于多晶硅薄膜自身应力较难控制,在工艺重复性不好的情况下,器件谐振频率会发生漂移,更重要的是,谐振结构内应力也会随着外界环境温度的变化而变化,从而导致频率的漂移。
技术实现要素:
4.为了改善上述谐振结构内应力随着外界环境温度的变化而大幅度变化的问题,本技术实施例中提供了一种mems器件及其制备方法。
5.根据本技术实施例的第一个方面,提供了一种mems器件,包括:衬底;基于所述衬底形成的第一电极层;位于第一电极层上的第二电极层,所述第二电极层包括横梁与锚点;所述横梁悬置于所述第一电极上,所述横梁沿第一方向延伸且具有相对设置的两端,所述横梁沿第二方向具有相对设置的两侧,所述第一方向和所述第二方向均垂直于衬底厚度方向,且所述第一方向垂直于所述第二方向;
6.所述横梁的至少一端设置有所述锚点,每个所述锚点包括两个锚固部,所述两个锚固部分别固定于所述横梁的两侧,且每个所述锚固部与所述第一电极层电接触。
7.在其中一种可能的实现方式中,所述锚固部包括连接段与固定段,所述连接段与所述横梁的一侧连接并沿第二方向延伸,所述固定段与所述连接段连接并沿所述第一方向延伸。
8.在其中一种可能的实现方式中,所述固定段沿所述第一方向具有相对的两端,其中至少一端超出所述连接段。
9.在其中一种可能的实现方式中,所述横梁包括主体段与外延段;所述主体段呈长条状并沿第一方向延伸;所述外延段设置在所述主体段沿所述第一方向的一端或两端,且所述外延段沿所述第二方向的两端均超出所述主体段;所述锚固部与所述外延段连接。
10.在其中一种可能的实现方式中,所述外延段沿所述第二方向具有相对设置的两个侧面;所述锚固部与所述外延段的侧面连接且沿所述第一方向延伸,且所述锚固部沿所述
第一方向的两端中至少其一超过所述外延段。
11.在其中一种可能的实现方式中,所述锚固部包括两部分;所述外延段沿所述第一方向具有相对设置的两个端面;每个所述端面各连接有所述锚固部的一部分。
12.在其中一种可能的实现方式中,所述第一电极层具有朝向所述第二电极层的顶面,所述顶面上形成有凹槽;所述锚固部与所述第一电极层的顶面电接触,所述横梁悬置于所述凹槽上。
13.在其中一种可能的实现方式中,所述第一电极层具有朝向所述第二电极层的顶面,所述顶面上形成有凹槽;至少部分所述锚固部位于所述凹槽内,所述横梁悬置于所述凹槽上。
14.在其中一种可能的实现方式中,所述第二电极层具有朝向所述第一电极层的底面,对应于横梁的底面上形成有凹槽以使横梁能够悬置于第一电极层上,对应于锚固部的底面与第一电极层电接触。
15.在其中一种可能的实现方式中,所述mems器件包括mems谐振器。
16.根据本技术实施例的第二个方面,提供了一种mems器件的制备方法,包括:在衬底上形成第一导电层,对第一导电层进行图案化处理,以形成第一电极层;在第一电极层上形成牺牲层,对所述牺牲层进行部分刻蚀以暴露出部分第一电极层;在第一电极层和牺牲层上形成第二导电层,对第二导电层进行图案化处理,暴露出牺牲层,且图案化后的第二导电层包括横梁与锚点,以形成第二电极层;所述横梁通过牺牲层与所述第一电极层间隔设置,所述横梁沿第一方向延伸且具有相对设置的两端,所述横梁沿第二方向具有相对设置的第一侧与第二侧,所述第一方向和所述第二方向均垂直于衬底厚度方向,且所述第一方向垂直于所述第二方向;所述横梁的至少一端连接有所述锚点,每个所述锚点包括两个锚固部,所述两个锚固部分别固定于所述横梁的第一侧与所述横梁的第二侧,且每个所述锚固部与所述第一电极层电接触;去除所述牺牲层,以使所述横梁悬置于所述第一电极层上。
17.在其中一种可能的实现方式中,所述mems器件包括mems谐振器。
18.本技术实施例中提供的mems器件及其制备方法,其层叠设置的第一电极和第二电极中,位于上方的第二电极包括横梁与锚点,其中,横梁悬空设置在第一电极上,二者之间有预设间距;锚点与第一电极接触且电连接,且锚点包括的两个锚固部之间以横梁间隔且分别设置在横梁两侧。通过上述锚点结构的设置,能够有效避免横梁弯曲,利于提高mems器件的性能。
19.特别是,通过将每个锚固部分成两部分,并分别设置在横梁外延部的两端,能够进一步改善横梁结构内应力随着外界环境温度的变化而大幅度变化的缺陷。
附图说明
20.此处所说明的附图用来提供对本技术的进一步理解,构成本技术的一部分,本技术的示意性实施例及其说明用于解释本技术,并不构成对本技术的不当限定。在附图中:
21.图1为相关技术中mems谐振器的上电极层的俯视图;
22.图2为图1示出的上电极在外界温度变化前后的示意图。
23.图3为本技术实施例提供的一种mems器件的俯视图;
24.图4为本技术实施例提供的另一种mems器件的俯视图;
25.图5为本技术实施例提供的又一种mems器件的俯视图;
26.图6为本技术实施例提供的再一种mems器件的俯视图;
27.图7为本技术实施例提供的一种mems器件的剖视图;
28.图8为本技术实施例提供的另一种mems器件的剖视图;
29.图9为本技术实施例提供的又一种mems器件的剖视图;
30.图10为本技术实施例提供的再一种mems器件的剖视图;
31.图11a-图11k为图10示出的mems器件的制造流程的剖视图。
32.主要附图标记:
33.100-衬底;
34.200-接地层;
35.300-隔离层;310-氮化硅层;320-氧化硅层;
36.400-第一电极层;410-凹槽;411-小截面槽;412-大截面槽;
37.500-牺牲层;
38.600-第二电极层;610-横梁;611-主体段;612-外延段;621-第一锚固部;6211-第一连接段;6212-第一固定段;6213-第一接头段;622-第二锚固部;6221-第二连接段;6222-第二固定段;6223-第二接头段;
39.710-上电极;711-锚点部;712-横梁部;720-下电极。
具体实施方式
40.下面以mems谐振梁器件为例,说明本发明的具体实施方式。图1为相关技术中mems谐振器的上电极层的俯视图,图2为图1示出的上电极在外界温度变化前后的示意图。参考图1与图2,在相关技术中,mems谐振器包括层叠设置的上电极710与下电极720。其中,上电极710可包括锚点部711与横梁部712,锚点部711可固定在横梁部712的一端且与下电极720连接,并使得横梁部712的另一端悬空设置于下电极720。也就是说,横梁部712远离锚点部711的一端为自由端。并且,锚点部711的宽度与横梁部712的宽度相同。
41.参考图2,在初始温度下,上电极710的横梁部712a与下电极720基本保持平行。温度升高后,横梁部712a发生形变,朝向下电极720方向弯曲,即图2中的横梁部712b,此外横梁部712b相比于横梁部712a伸长了一定尺寸,记为δd1,并且横梁部712的自由端与下电极720之间的间隙发生了较为明显的变化,从而影响了谐振频率,导致了温度漂移的产生。
42.针对上述问题,本技术发明人经试验和多次仿真,认为原因很可能在于,在温度发生变化时,由于热胀冷缩,在锚点部的位置会产生内应力,此应力的大小应与锚点部的形状和所在位置有关。特别是仿真结果表明,当将锚点部设置在靠近横梁部的端部的侧壁位置时,横梁部的自由端随温度变化的幅度变小,推测极有可能是此种设置方式降低了内应力。
43.有鉴于此,本技术实施例提供的mems器件通过将两个锚点部分别设置在横梁的两侧,使得锚点部与横梁之间的连接位置位于横梁的侧面,以减小内应力,进而有效避免横梁因温度变化导致的弯曲。
44.为了使本技术实施例中的技术方案及优点更加清楚明白,以下结合附图对本技术的示例性实施例进行进一步详细的说明,显然,所描述的实施例仅是本技术的一部分实施例,而不是所有实施例的穷举。需要说明的是,在不冲突的情况下,本技术中的实施例及实
施例中的特征可以相互组合。
45.以下以mems谐振器为例对本技术实施例的技术方案进行阐释。图3-图6为本技术实施例提供的mems器件的不同实施方式的俯视图。图7-图10为本技术实施例提供的mems器件的不同实施方式的剖视图。参考图3-图10,本技术实施例提供的mems器件可包括衬底100、第一电极层400以及包括横梁和锚点的第二电极层600。
46.其中,衬底100可为半导体衬底、半导体化合物衬底或是soi(semiconductor over insulator)衬底。半导体衬底具体可以为硅衬底。半导体化合物衬底具体可以为碳化硅衬底、硅化锗衬底、砷化镓衬底等。
47.参考图7-图10,第一电极层400可形成于衬底100上。以下为方便说明,将第一电极层400朝向衬底100的表面称为底面,将第一电极层400背离衬底100的表面称为顶面。第一电极层400可具有凹槽410,且该凹槽410可具有朝上(沿图中z方向)设置的槽口。第二电极层600可形成在第一电极层400远离衬底100的一侧,即第二电极层600位于第一电极层400的顶面上,且第二电极层600可包括横梁610。
48.参考图3-图6,横梁610可沿第一方向x(如图中x方向和x方向的反方向)延伸,且横梁610沿第一方向x可具有相对设置的第一端与第二端。参考图7-图10,横梁610相对于第一电极层400悬空设置,横梁610与凹槽410的槽底具有一定的间距。
49.为了实现横梁610与第一电极层400之间的电连接,第二电极层600还包括锚点。参考图3-图10,横梁沿第二方向y(如图中y方向和y方向的反方向)可具有相对设置的第一侧与第二侧,该第二方向y垂直于第一方向x,且第一方向x和第二方向y均垂直于图中的z方向。每个锚点包括两个锚固部,为方便阐释,本技术实施例将其分别称为第一锚固部621与第二锚固部622。图3-图6中的阴影区域表示锚固部,图7-图10中通过虚线可区分横梁610与锚固部。
50.其中,横梁610可为图3-图5示出的悬臂梁,对于悬臂梁,仅横梁610的一端设有锚点。此外,横梁610也可为图6示出的双端固定梁,即横梁610的第一端和第二端均分别连接有锚点。
51.示例性地,参考图3-图5,在横梁610为悬臂梁时,第一锚固部621和第二锚固部622可均连接在横梁610的第一端或者横梁610的第二端。图3-图5以第一锚固部621和第二锚固部622均连接在横梁610的第一端为例示出。
52.其中,横梁610的形状可为图3示出的长条状,横梁610的形状也可为图4与图5示出的t形。
53.一示例性地,参考图3,在横梁610的形状为长条状时,横梁610沿第二方向y可具有相对设置的第一侧面与第二侧面。第一锚固部621可设置在横梁610的第一侧,且第一锚固部621的侧面可与横梁610的第一侧面连接。第二锚固部622可设置在横梁610的第二侧,且第二锚固部622的侧面可与横梁610的第二侧面连接。如此,第一锚固部621与第二锚固部622在第二方向y上存在一定的间距,以使得第二电极层600与第一电极层400的两个连接处分列在第二电极层600在第二方向y上的两端,进而减小横梁610因温度变化而产生的内应力,避免横梁610发生大幅度弯曲形变,从而利于提高mems器件的性能。
54.参考图7-图10,第三方向z(可视为衬底厚度方向,参考图中的z方向和z方向的反方向)可垂直于第一方向x与第二方向y所构成的平面。第一锚固部621在第三方向z上可具
有相对设置的顶面与底面。第一锚固部621的底面可与第一电极层400的顶面接触并电连接。为了提高第一锚固部621与第一电极层400之间的连接强度,可选地,结合图3,第一锚固部621可包括第一连接段6211与第一固定段6212。其中第一连接段6211可与横梁610的第一侧面连接并可沿所述第二方向y延伸。第一固定段6212可与第一连接段6211连接并可沿第一方向x延伸。如此,以便通过增加第一锚固部621与第一电极层400之间的接触连接面积,提高连接强度。
55.进一步地,第一固定段6212沿第一方向x可具有相对设置的第一端与第二端。第一固定段6212的两端中,至少一端超出第一连接段6211。换言之,有如下三种情况:情况一、仅第一固定段6212的第一端超出第一连接段6211;情况二、仅第一固定段6212的第二端超出第一连接段6211;情况三、如图3中示出的,第一固定段6212的第一端超出第一连接段6211,且第一固定段6212的第二端超出第一连接段6211。
56.同理,可选地,第二锚固部622可包括第二连接段6221与第二固定段6222。第二连接段6221可与横梁610的第一侧面连接并可沿第二方向y延伸。第二固定段6222可与第二连接段6221连接并可沿第一方向x延伸。如此,以便通过增加第二锚固部622与第一电极层400之间的接触和连接面积,提高连接强度。
57.进一步地,第二固定段6222沿第一方向x可具有相对设置的第一端与第二端。第二固定段6222的第一端可超出第二连接段6221;或,第二固定段6222的第二端可超出第二连接段6221;或,第二固定段6222的第一端可超出第二连接段6221,且第二固定段6222的第二端可超出第二连接段6221。比如图3所示的结构中,第二固定段6222沿第一方向x的两端均超出第二连接段6221。
58.另一示例性地,参考图4与图5,横梁610可包括主体段611与外延段612。主体段611的形状可为长条状。外延段612可设置在主体段611沿第一方向x的一端,且外延段612沿第二方向y的两端可均超出主体段611。比如横梁610整体呈t字形。
59.其中,第一锚固部621与第二锚固部622可存在如下几种可能的实现方式:
60.在其中一种可能的实现方式中,如图4所示,外延段612沿第二方向y可具有相对设置的两个侧面。第一锚固部621可设置在外延段612的一侧,且第一锚固部621的侧面可与外延段612的其中一个侧面连接。其中,为了提高第一锚固部621与第一电极层400的连接强度,可选地,第一锚固部621可沿第一方向x延伸,且第一锚固部621沿第一方向x的两端可均超过外延段612。
61.同理,第二锚固部622可设置在外延段612的另一侧,且第二锚固部622的侧面可与外延段612的另一侧面连接。为了提高第二锚固部622与第一电极层400的连接强度,可选地,第二锚固部622可沿第一方向x延伸,且第二锚固部622沿第一方向x的两端可均超过外延段612。
62.第一锚固部621与第二锚固部622采用上述方式时,可以进一步加大第一锚固部621与第二锚固部622在第二方向y上的间距,以使得第二电极层600与第一电极层400的两个连接处间隔的距离较远,进而减小横梁610因温度变化而产生的内应力,避免横梁610弯曲,利于提高mems器件的性能。
63.在另一种可能的实现方式中,外延段612沿第一方向x可具有相对设置的两个端面。第一锚固部621可与外延段612的端面沿第二方向y的一端连接,第二锚固部622可与外
延段612的端面沿第二方向y的另一端连接。如此,第二电极层600与第一电极层400的两个连接处间隔的距离较远,并且可使得两个电极层之间具有较大的连接力,可避免横梁610弯曲,利于提高mems器件的性能。
64.其中,可选地,参考图5,为了提高外延段612在振动时的稳定性,第一锚固部621可包括两部分,每个部分均记为第一接头段6213。这两个第一接头段6213可相对设置,且可分别与外延段612沿第一方向x的两个相对的端面连接。同理,第二锚固部622可包括两个第二接头段6223。这两个第二接头段6223可相对设置,且可分别与外延部612沿第一方向x的两个相对的端面连接。
65.参考图6,在横梁610为双端固定梁时,横梁610沿第一方向x可具有相对设置的第一端与第二端,每端均连接有锚点,每个锚点均包括第一锚固部621和第二锚固部622。其中,第一锚固部621和第二锚固部622与横梁610两端连接的方式可参考上文,图6只是以横梁610的形状为长条状为例示出,并不做具体限定。
66.需要说明的是,对于电容式mems谐振器,其主要结构为静电电容,该静电电容的其中一个电极板为可动电极板,其包括上述的第一电极层和第二电极层,该静电电容的另一个电极板可采用常规结构,不属于本技术重点讨论的内容,因此不再赘述。当然,对于电容式mems谐振器,除了上述衬底、电极外,还包括诸如接地层等其它结构,其同样可采用常规结构,也不再赘述。
67.下面参考图7-图10来描述本技术实施例提供的mems器件的第一锚固部621与第二锚固部622的纵向结构,该结构可适用于横梁610为悬臂梁以及横梁610为双端固定梁。
68.示例性地,参考图7与图8,第一电极层400沿第三方向z可具有相对设置的顶面与底面,其中顶面朝向第二电极层600,底面朝向衬底100;第一电极层400的顶面上设有朝向底面凹陷的凹槽410;当然,凹槽410的深度小于第一电极层400的厚度。第一锚固部621与第二锚固部622均可形成在第一电极层400的顶面并与第一电极层400的顶面电接触。横梁610相对于凹槽410的槽底悬空设置,且横梁610可如图7所示形成在凹槽410的外侧,或者,横梁610可如图8所示形成在凹槽410的内腔中。
69.另一示例性地,参考图9与图10,至少部分第一锚固部621与至少部分第二锚固部622可形成在第一电极层400的凹槽410中。
70.在其中一种方式中,参考图9,凹槽410可包括内底壁以及与内底壁连接的内侧壁。第一锚固部621的底面与第二锚固部622的底面可均与凹槽410的内底壁接触并连接。进一步地,第一锚固部621与第二锚固部622背离彼此的侧面可均与凹槽410的内侧壁连接,以便增大第一锚固部621与第一电极层400的接触面积以及第二锚固部622与第一电极层400的接触面积,用以增强连接强度。
71.在另一种方式中,参考图10,凹槽410可为阶梯槽,该凹槽410可包括相连通的小截面槽411与大截面槽412,大截面槽412相对更远离衬底100。一部分第一锚固部621与一部分第二锚固部622可形成在大截面槽412中,一部分第一锚固部621与一部分第二锚固部622可形成在第一电极层400的顶面。如此,以通过增加接触面积来提高连接强度。另外,进一步地,部分第一锚固部621与部分第二锚固部622也可形成在小截面槽411中。
72.需要说明的是,上述关于横梁610侧面与两个锚固部的侧面连接的内容,仅仅用于介绍三者之间的具体连接关系和位置关系,实际上横梁与锚固部材质相同,为一体化整体
结构,并且可在同一工艺步骤中形成。
73.图11a-图11k为图10示出的mems器件的制造流程的剖视图。参考图11a-图11k,mems器件的制造流程可以如下:
74.s101、参考图11a,提供衬底100。
75.s102、参考图11b,在衬底100上重掺浓硼得到接地层200。其中,接地层200的方块电阻例如小于3ω/
□
。
76.s103、参考图11c与图11d,在接地层200上形成隔离层300。其中,隔离层300可为单层结构,比如隔离层300为单层的氧化硅层或者单层的氮化硅层;图11c所示的结构中,隔离层300即为单层的氮化硅层310。隔离层300也可为多层结构,比如图11d所示的结构中,隔离层300包括层叠设置的氮化硅层310和氧化硅层320。以下以隔离层为多层结构为例继续说明mems器件的制造流程。另外,形成隔离层300的方式可采用pecvd(plasma enhanced chemical vapor deposition,等离子增强气相沉积)或lpcvd(low pressure vapor deposition,低压化学气相沉积)。
77.s104、参考图11e,在隔离层300远离接地层200的一侧形成第一导电层400
′
。其中,第一导电层400
′
具体可以选用掺杂多晶硅。另外,形成第一导电层400
′
的方式可以为lpcvd。
78.s105、参考图11f与图11g,对第一导电层400
′
进行图案化处理,形成第一电极层400。示例性地,参考图11f,可在第一导电层400
′
上涂覆光刻胶,然后对光刻胶进行图案化处理(如曝光和显影),以形成刻蚀窗口,暴露出待刻蚀的第一导电层400
′
;通过刻蚀窗口对第一导电层400
′
进行初步刻蚀,并在第一导电层400
′
中形成图11f中示出的大截面槽412,该大截面槽412的槽深小于第一导电层400
′
的厚度;随后,在初步刻蚀后的第一导电层400
′
上涂覆光刻胶,并对光刻胶进行图案化处理,暴露出待刻蚀的大截面槽412的部分槽底,以在大截面槽412的槽底形成刻蚀窗口;通过刻蚀窗口对第一导电层400
′
进行再次刻蚀,以形成图11g中示出的小截面槽411。如此,形成第一电极层400,其包括凹槽410,该凹槽410具有朝向上方的槽口,且该凹槽410为阶梯槽。
79.s106、参考图11h,在第一电极层400远离隔离层300的一侧形成牺牲层500。示例性地,在小截面槽411、大截面槽412内以及在第一电极层400的顶面上形成牺牲层500。当然在实践中,在形成第一电极层400的过程中也暴露出了部分隔离层300的顶面,因此牺牲层500同样也覆盖该部分隔离层300。
80.牺牲层500可选用氧化硅或磷硅玻璃(psg)并通过pecvd或lpcvd等工艺得到,在此不赘述。
81.s107、参考图11i,刻蚀牺牲层500。示例性地,可在牺牲层500上涂覆光刻胶,然后对光刻胶进行图案化处理,以形成刻蚀窗口,暴露出待刻蚀的牺牲层500;通过刻蚀窗口对牺牲层500进行刻蚀,以去除形成在大截面槽412槽内和形成在第一电极层400以及隔离层300上的牺牲层500,只保留形成在小截面槽411槽内的牺牲层。当然,图11i示出的结构中,刻蚀剩余的牺牲层500的顶面几乎与小截面槽411的槽口(或者说大截面槽412的槽底)齐平,在其它实现方式中,剩余的牺牲层500的顶面可以略低于小截面槽411的槽口或高出小截面槽411的槽口。
82.s108、参考图11j,在牺牲层500和第一电极层400上形成第二导电层600
′
。示例性
地,第二导电层600
′
填充于大截面槽412内并覆盖第一电极层400和牺牲层500。其中,第二导电层600
′
的材料也可以为掺杂多晶硅。另外,形成第二导电层600
′
的方式可为lpcvd。
83.参考图11k,s109、对第二导电层600
′
进行图案化处理,获得第二电极层600。示例性地,可在第二导电层600
′
表面涂覆光刻胶,并对光刻胶进行图案化处理,以形成刻蚀窗口,暴露出待刻蚀的第二导电层600
′
;通过刻蚀窗口对第二导电层600
′
进行刻蚀,以去除形成在第一电极层400顶面的至少部分第二电极层600。
84.s110、参考图10,去除牺牲层500,以释放横梁610。示例性地,可在刻蚀形成第二电极层600的过程中,同步在横梁610上刻蚀形成多个贯穿孔,然后采用如vhf(vapor hydrogen fluoride,气相氟化氢)等腐蚀材料去除牺牲层500。
85.以上结合图11a-图11k阐释了图10示出的mems器件的制造流程。对于图7-图9示出的mems器件的制造流程,本领域技术人员人员可参考图11a-图11k以及相关文字说明进行简单推导得到。在此就不再赘述。
86.需要说明的是,图7至图10所示的mems器件的结构中,均是首先形成具有凹槽的第一电极层,然后基于牺牲层实现第二电极层中横梁的悬空,且横梁的形状基本取决于牺牲层的形状,锚点的构造取决于凹槽的形状以及牺牲层的厚度和图案化情况。在其它实施例中,也可以不在第一电极层中形成凹槽,而是通过对牺牲层进行图案化处理,以暴露出部分第一电极层而便于与后续形成的第二电极层电接触(此接触的部分后续形成锚点),并使得对应于横梁部分的牺牲层高出第一电极层的顶面,这样后续形成的第二电极层因随形而形成凹槽,该凹槽的槽底背离第一电极层且槽口朝向第一电极层,这样在去除牺牲层后,第二电极层的横梁部分能够悬置于第一电极层上。
87.以上以mems谐振梁器件为例对本技术实施例的技术方案进行阐释。在其它实施例中,所有具有悬臂梁或双端固支梁等带有锚点固定端的mems器件,均可以采用上述结构。
88.在本技术的描述中,需要理解的是,术语“中心”、“纵向”、“横向”、“长度”、“宽度”、“厚度”、“上”、“下”、“前”、“后”、“左”、“右”、“竖直”、“水平”、“顶”、“底”“内”、“外”等指示的方位或位置关系为基于附图所示的方位或位置关系,仅是为了便于描述本技术和简化描述,而不是指示或暗示所指的装置或元件必须具有特定的方位、以特定的方位构造和操作,因此不能理解为对本技术的限制。
89.此外,术语“第一”、“第二”仅用于描述目的,而不能理解为指示或暗示相对重要性或者隐含指明所指示的技术特征的数量。由此,限定有“第一”、“第二”的特征可以明示或者隐含地包括一个或者更多个该特征。在本技术的描述中,“多个”的含义是至少两个,例如两个,三个等,除非另有明确具体的限定。
90.尽管以上已描述了本技术的优选实施例,但是,在不脱离本技术的精神和/或超出本技术权利要求范围的情况下,本领域内的技术人员可在这些实施例之外作出其它的修改和变型,这些修改和变型应属于本技术权利要求及其等同技术的范围之内。
相关技术
网友询问留言
已有0条留言
- 还没有人留言评论。精彩留言会获得点赞!
1