MEMS压电传感器系统三维封装结构及其散热方法
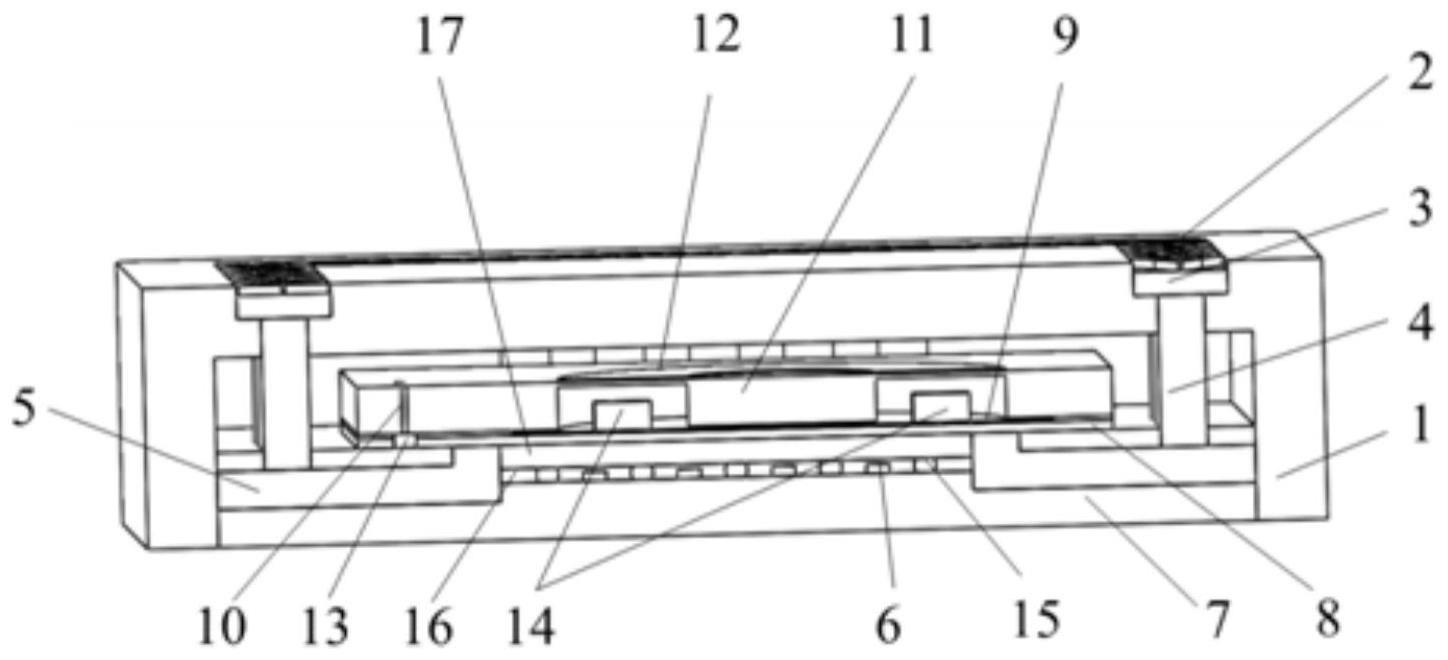
mems压电传感器系统三维封装结构及其散热方法
技术领域
1.本发明为微机电技术领域,具体涉及一种mems压电传感器系统三维封装结构及其散热方法。
背景技术:
2.mems传感器是人工智能、物联网、机器人、无人驾驶和ar/vr等行业的感知层核心器件,利用集成电路制造和微加工技术,将微机械和微电子按功能封装在一块或多块芯片上组成微型集成系统,其内部通常包括微处理器和获取外界信息的微型传感器,能够感知和处理来自外界的各种声、光、电、热、力、磁等信号,具有集成度高、体积小、传输速率快等优点。
3.目前,对于mems传感芯片与asic微处理器芯片的集成通常采用二维系统级封装方式,即通过并排放置和引线键合连接mems与asic芯片,因其成本低,成为大多数mems器件的主要集成方法。然而,二维封装形式所占面积较大、互连线较长、寄生参数大,难以顺应mems高度集成化、小型化的发展趋势,严重制约了mems的更新换代。mems三维封装可以通过垂直堆叠接触来大大降低封装面积,缩短集成电路连接长度,加快信号传输速度,还能有效减小互连线间寄生效应,降低系统功耗,极大地克服了二维封装存在的缺点。但是三维集成造成系统内部具有更高的集成密度,导致结构组件在工作时出现芯片之间热量累积在内部无法外传的情况,热量持续过高会导致封装体内会产生热应力,引发芯片翘曲和变形,严重影响微传感器的精度以及芯片的可靠性。
技术实现要素:
4.本发明的目的在于提供一种mems压电传感器系统三维封装结构及其散热方法。
5.本发明mems压电传感器系统三维封装结构,主要由盖帽、表面微结构、铜环、圆柱阵列以及置于盖帽内的水平延展平台、水平网状结构、陶瓷基板、mems芯片、压电薄膜、微型温度传感器、焊球和asic芯片组成;所述的陶瓷基板开设有中心槽口,并在中心槽口的侧壁开设有沿周向均布的n个安置槽,n≥3;每个安置槽内均嵌有水平延展平台;所述的水平网状结构焊接在陶瓷基板的中心槽口内,并与各水平延展平台的内端均焊接;水平网状结构的每个网孔内均设有一个焊球;所述焊球的底部与基板焊接,顶部与asic芯片焊接,各焊球外围填充有环氧树脂;asic芯片与基板通过各焊球通信;所述的mems芯片与陶瓷基板的上表面通过导热胶粘结,且mems芯片下表面通过玻璃真空密封。mems芯片的上表面开设有环槽,环槽内设有压电薄膜和两个微型温度传感器,且压电薄膜罩住两个微型温度传感器;压电薄膜的信号线穿过mems芯片上的硅通孔和玻璃上的玻璃通孔,与陶瓷基板内埋的导线连接;微型温度传感器位于asic芯片上方,微型温度传感器的信号线穿过玻璃上的玻璃通孔,与陶瓷基板内埋的导线连接;基板内埋的各导线连接asic芯片;盖帽的内侧壁与基板外侧壁焊接;盖帽的上表面开设有沉头式环形通槽,所述沉头式环形通槽两个不同宽度的槽段之间形成过渡台阶;铜环置于沉头式环形通槽的过渡台阶上,并与盖帽焊接;各水平延展平
台均与铜环通过一个圆柱阵列连接;所述的圆柱阵列由等距布置的多个圆柱组成;圆柱的下表面焊接在水平延展平台上,上表面与铜环下表面焊接;铜环上焊接有表面微结构,表面微结构的上表面与盖帽上表面平齐。
6.优选地,所述的水平延展平台与安置槽过渡配合。
7.更优选地,所述安置槽的内端设有台阶,台阶比安置槽的底部高出0.01-0.05mm。
8.优选地,所述的表面微结构由沿铜环环向布置的多个微结构组组成,所述的微结构组由排列成两排的三个等边三角形微结构单元组成。
9.优选地,所述的水平网状结构由多条垂直相交的金属条组成,且水平网状结构的各网孔大小相等。
10.该mems压电传感器系统三维封装结构的散热方法,具体如下:
11.asic芯片区域的热量经水平网状结构和水平延展平台向盖帽水平传递;水平延展平台上垂直焊接的圆柱阵列使asic芯片区域的热量向上传导至铜环,铜环上焊接的表面微结构增加盖帽上表面的对流换热面积,加快对流换热效率;其中,mems芯片的环槽内位于asic芯片区域上方粘接的微型温度传感器对asic芯片区域的温度进行实时监测。
12.本发明具有的有益效果是:
13.1、本发明将asic芯片埋入陶瓷基板中,并采用tsv技术将mems芯片与asic芯片进行垂直堆叠,实现mems芯片与asic芯片的三维集成,并利用封装结构空间内嵌三维散热结构(表面微结构、铜环、水平网状结构、水平延展平台及圆柱阵列),实现对mems压电传感器系统的有效散热。
14.2、本发明通过在asic芯片底部粘接水平网状结构,可在不影响电信号传输的基础上,将asic芯片核心发热区域的热量进行及时疏散到四周,不仅降低核心区最高温度,还大大减小了mems压电传感器系统内部的温度梯度。
15.3、本发明通过在水平网状结构四周焊接水平延展平台,进一步将asic芯片核心区域热量水平传导到封装结构外表面,大大提高了水平散热效率。
16.4、本发明通过在水平散热基础上,垂直焊接圆柱阵列及表面微结构,不仅实现了热量在垂直方向上的传导,且加快了mems压电传感器系统上表面的空气对流换热效率,充分利用三维空间进行散热,其散性能好,效率高。
17.5、本发明的三维散热结构均采用导热系数和电导率高的铜材料,不仅散热性能好,且对于外界的电磁干扰起到了良好的屏蔽作用。
18.6、利用mems芯片的环槽,将系统测温所需的微型温度传感器胶粘在的环槽内,实现了在密闭空间中实时监测系统内部最高温度的目的,防止因温度过高导致芯片失效。
附图说明
19.图1为本发明的整体结构装配图;
20.图2为本发明的内部结构布置示意图;
21.图3为本发明的mems压电传感器、圆柱阵列、水平延展平台和陶瓷基板的装配示意图;
22.图4为本发明中水平网状结构和焊球的空间位置示意图;
23.图5为本发明中表面微结构、铜环、圆柱阵列和水平延展平台的装配示意图;
24.图6为本发明中表面微结构的示意图;
25.图7为本发明中水平网状结构、水平延展平台及圆柱阵列的相对位置示意图。
具体实施方式
26.以下结合附图对本发明作进一步说明。
27.如图1至图7所示,mems压电传感器系统三维封装结构,主要由盖帽1、表面微结构2、铜环3、圆柱阵列4以及置于盖帽1内的水平延展平台5、水平网状结构6、陶瓷基板7、mems芯片11、压电薄膜12、微型温度传感器14、焊球15和asic芯片17组成;陶瓷基板7开设有中心槽口,并在中心槽口的侧壁开设有沿周向均布的n个安置槽,n≥3;每个安置槽内均嵌有水平延展平台5,水平延展平台5将热量向盖帽1传导;水平网状结构6焊接在陶瓷基板7的中心槽口内,并与各水平延展平台5的内端均焊接;水平网状结构6的每个网孔内均设有一个焊球15;焊球15底部与基板7焊接,顶部与asic芯片17焊接,各焊球外围填充有环氧树脂16;asic芯片17与基板7通过各焊球15通信;mems芯片11与陶瓷基板7的上表面通过导热胶8粘结,且mems芯片11下表面通过玻璃9真空密封。mems芯片11的上表面开设有环槽,环槽内设有压电薄膜12和两个微型温度传感器14,且压电薄膜12罩住两个微型温度传感器14;mems芯片11和压电薄膜12组成mems压电传感器;压电薄膜12的信号线穿过mems芯片11上的硅通孔(tsv)10和玻璃9上的玻璃通孔(tgv)13,与陶瓷基板7内埋的导线连接,基板7内埋的导线连接asic芯片17,进而实现了mems压电传感器与asic芯片之间的通信;微型温度传感器14对来自asic芯片17的系统高温核心区域进行实时温度监测,微型温度传感器14的信号线穿过玻璃9上的玻璃通孔,与陶瓷基板7内埋的导线连接,基板7内埋的导线连接asic芯片17;盖帽1的作用是对整个mems系统进行密封,盖帽1的内侧壁与基板7外侧壁焊接;盖帽1的上表面开设有沉头式环形通槽,沉头式环形通槽两个不同宽度的槽段之间形成过渡台阶;铜环3置于沉头式环形通槽的过渡台阶上,并与盖帽1焊接;各水平延展平台5均与铜环3通过一个圆柱阵列4连接;圆柱阵列4由等距布置的多个圆柱组成;圆柱的下表面焊接在水平延展平台5上,上表面与铜环3下表面焊接;铜环3上焊接有表面微结构2,表面微结构2的上表面与盖帽1上表面平齐。
28.作为一个优选实施例,水平延展平台5与安置槽过渡配合。
29.更优选地,安置槽的内端设有台阶,台阶比安置槽的底部高出0.01-0.05mm,台阶侧面有利于快速导出asic芯片17的热量。
30.作为一个优选实施例,如图6所示,表面微结构2由沿铜环3环向布置的多个微结构组组成,微结构组由排列成两排的三个等边三角形微结构单元组成,进而增大封装结构外表面与空气之间的对流换热面积。
31.作为一个优选实施例,水平网状结构6由多条垂直相交的金属条组成,且水平网状结构6的各网孔大小相等。
32.该mems压电传感器系统三维封装结构的散热方法,具体如下:
33.首先,本发明基于热传导原理,在mems压电传感器系统工作过程中温度最高的asic芯片区域粘结水平网状结构,在水平网状结构四周焊接水平延展平台,使热量从高温asic芯片区域进一步向盖帽1水平传递。其次,在水平延展平台上,垂直焊接圆柱阵列,使热量由下面高温asic芯片区域向上面低温区域进行传导,此外,在圆柱阵列上表面焊接铜环,
铜环上焊接表面微结构,增加盖帽上表面的对流换热面积,加快对流换热效率。最后,利用mems芯片的环槽,在高温asic芯片区域粘接微型温度传感器,对asic芯片区域的温度进行实时监测。可见,本发明mems压电传感器系统三维封装结构可进行有效散热,并对内部最高温度区域进行实时监测。
相关技术
网友询问留言
已有0条留言
- 还没有人留言评论。精彩留言会获得点赞!
1